1. 在流程上吸收到的资料是否完好(包括:事理图、.brd文件、料单、PCB设计解释以及PCB设计或变动哀求、标准化哀求解释、工艺设计解释文件)
2. 确认PCB模板是最新的

3. 确认模板的定位器件位置无误
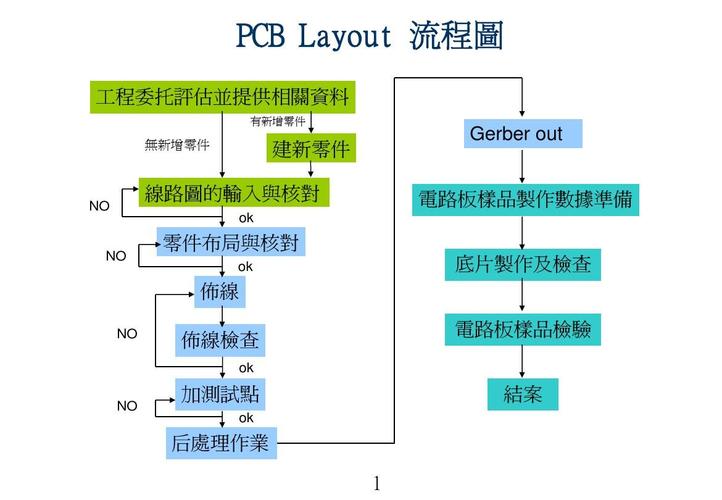
4. PCB设计解释以及PCB设计或变动哀求、标准化哀求解释是否明确
5. 确认形状图上的禁止布放器件和布线区已在PCB模板上表示
6. 比较形状图,确认PCB所标注尺寸及公差无误, 金属化孔和非金属化孔定义准确
7. 确认PCB模板准确无误后最好锁定该构造文件,以免误操作被移动位置
布局后检讨阶段
器件检讨
1. 确认所有器件封装是否与公司统一库同等,是否已更新封装库(用viewlog检讨运行结果)如果不一致,一定要Update Symbols
2. 母板与子板,单板与背板,确认旗子暗记对应,位置对应,连接器方向及丝印标识精确,且子板有防误插方法,子板与母板上的器件不应产生干涉
3. 元器件是否100% 放置
4. 打开器件TOP和BOTTOM层的place-bound, 查看重叠引起的DRC是否许可
5. Mark点是否足够且必要
6. 较重的元器件,该当布放在靠近PCB支撑点或支撑边的地方,以减少PCB的翘曲
7. 与构造干系的器件布好局后最好锁住,防止误操作移动位置
8. 压接插座周围5mm范围内,正面不许可有高度超过压接插座高度的元件,背面不许可有元件或焊点
9. 确认器件布局是否知足工艺性哀求(重点关注BGA、PLCC、贴片插座)
10. 金属壳体的元器件,特殊把稳不要与其它元器件相碰,要留有足够的空间位置
11. 接口干系的器件只管即便靠近接口放置,背板总线驱动器只管即便靠近背板连接器放置
12. 波峰焊面的CHIP器件是否已经转换成波峰焊封装
13. 手工焊点是否超过50个
14. 在PCB上轴向插装较高的元件,该当考虑卧式安装。留出卧放空间。并且考虑固定办法,如晶振的固定焊盘
15. 须要利用散热片的器件,确认与其它器件有足够间距,并且把稳散热片范围内紧张器件的高度
功能检讨
1. 数模稠浊板的数字电路和仿照电路器件布局时是否已经分开,旗子暗记流是否合理
2. A/D转换器跨模数分区放置
3. 时钟器件布局是否合理
4. 高速旗子暗记器件布局是否合理
5. 端接器件是否已合理放置(源端匹配串阻应放在旗子暗记的驱动端;中间匹配的串阻放在中间位置;终端匹配串阻应放在旗子暗记的吸收端)
6. IC器件的去耦电容数量及位置是否合理
7. 旗子暗记线以不同电平的平面作为参考平面,当超过平面分割区域时,参考平面间的连接电容是否靠近旗子暗记的走线区域
8. 保护电路的布局是否合理,是否利于分割
9. 单板电源的保险丝是否放置在连接器附近,且前面没有任何电路元件
10. 确认强旗子暗记与弱旗子暗记(功率相差30dB)电路分开布设
11. 是否按照设计指南或参考成功履历放置可能影响EMC实验的器件。如:面板的复位电路要稍靠近复位按钮
发热
1. 对热敏感的元件(含液态介质电容、晶振)只管即便阔别大功率的元器件、散热器等热源
2. 布局是否知足热设计哀求,散热通道(根据工艺设计文件来实行)
电源
1. 是否IC电源间隔IC过远
2. LDO及周围电路布局是否合理
3. 模块电源等周围电路布局是否合理
4. 电源的整体布局是否合理
规则设置
1. 是否所有仿真约束都已经精确加到Constraint Manager中
2. 是否精确设置物理和电气规则(把稳电源网络和地网络的约束设置)
3. Test Via、Test Pin的间距设置是否足够
4. 叠层的厚度和方案是否知足设计和加工哀求
5. 所有有特性阻抗哀求的差分线阻抗是否已经经由打算,并用规则掌握
布线后检讨阶段
数模
1. 数字电路和仿照电路的走线是否已分开,旗子暗记流是否合理
2. A/D、D/A以及类似的电路如果分割了地,那么电路之间的旗子暗记线是否从两地之间的桥接点上走(差分线例外)
3. 必须超过分割电源之间间隙的旗子暗记线应参考完全的地平面
4. 如果采取地层设计分区不分割办法,要确保数字旗子暗记和仿照旗子暗记分区布线
时钟和高速部分
1. 高速旗子暗记线的阻抗各层是否保持同等
2. 高速差分旗子暗记线和类似旗子暗记线,是否等长、对称、就近平行地走线
3. 确认时钟线只管即便走在内层
4. 确认时钟线、高速线、复位线及其它强辐射或敏感线路是否已只管即便按3W原则布线
5. 时钟、中断、复位旗子暗记、百兆/千兆以太网、高速旗子暗记上是否没有分叉的测试点
6. LVDS等低电平旗子暗记与TTL/CMOS旗子暗记之间是否只管即便知足了10H(H为旗子暗记线距参考平面的高度)
7. 时钟线以及高速旗子暗记线是否避免穿越密集通孔过孔区域或器件引脚间走线
8. 时钟线是否已知足(SI约束)哀求(时钟旗子暗记走线是否做到少打过孔、走线短、参考平面连续,紧张参考平面只管即便是GND;若换层时变换了GND主参考平面层,在离过孔200mil范围之内是GND过孔;若换层时变换不同电平的主参考平面,在离过孔200mil范围之内是否有去耦电容)
9. 差分对、高速旗子暗记线、各种BUS是否已知足(SI约束)哀求
EMC与可靠性
1. 对付晶振,是否在其下布一层地;是否避免了旗子暗记线从器件管脚间穿越;对高速敏感器件,是否避免了旗子暗记线从器件管脚间穿越
2. 单板旗子暗记走线上不能有锐角和直角(一样平常成 135 度角连续转弯,射频旗子暗记线最好采取圆弧形或经由打算往后的切角铜箔)
3. 对付双面板,检讨高速旗子暗记线是否与其回流地线紧挨在一起布线;对付多层板,检讨高速旗子暗记线是否只管即便紧靠地平面走线
4. 对付相邻的两层旗子暗记走线,只管即便垂直走线
5. 避免旗子暗记线从电源模块、共模电感、变压器、滤波器下穿越
6. 只管即便避免高速旗子暗记在同一层上的长间隔平行走线
7. 板边缘还有数字地、仿照地、保护地的分割边缘是否有加屏蔽过孔;多个地平面是否用过孔相连;过孔间隔是否小于最高频率旗子暗记波长的1/20
8. 浪涌抑制器件对应的旗子暗记走线是否在表层短且粗
9. 确认电源、地层无孤岛、无过大开槽、无由于通孔隔离盘过大或密集过孔所造成的较长的地平面裂痕、无苗条条和通道狭窄征象
10. 是否在旗子暗记线跨层比较多的地方,放置了地过孔(至少须要两个地平面)
电源和地
1. 如果电源/地平面有分割,只管即便避免分割开的参考平面上有高速旗子暗记的超过
2. 确认电源、地能承载足够的电流。过孔数量是否知足承载哀求(估算方法:外层铜厚1oz时1A/mm线宽,内层0.5A/mm线宽,短线电流更加)
3. 对付有分外哀求的电源,是否知足了压降的哀求
4. 为降落平面的边缘辐射效应,在电源层与地层间要只管即便知足20H原则(条件许可的话,电源层的缩进得越多越好)
5. 如果存在地分割,分割的地是否不构成环路
6. 相邻层不同的电源平面是否避免了交叠放置
7. 保护地、-48V地及GND的隔离是否大于2mm
8. -48V地是否只是-48V的旗子暗记回流,没有汇接到其他地;如果做不到请在备注栏解释缘故原由
9. 靠近带连接器面板处是否布10~20mm的保护地,并用双排交错孔将各层相连
10. 电源线与其他旗子暗记线间距是否间隔知足安规哀求
禁布区
1. 金属壳体器件和散热器件下,不应有可能引起短路的走线、铜皮和过孔
2. 安装螺钉或垫圈的周围不应有可能引起短路的走线、铜皮和过孔
3. 设计哀求中预留位置是否有走线
4. 非金属化孔内层离线路及铜箔间距应大于0.5mm(20mil),外层0.3mm(12mil),单板起拔扳手轴孔内层离线路及铜箔间距应大于2mm(80mil)
5. 铜皮和线到板边 推举为大于2mm 最小为0.5mm
6. 内层地层铜皮到板边 1 ~ 2 mm, 最小为0.5mm
焊盘出线
1. 对付两个焊盘安装的CHIP元件(0805及其以下封装),如电阻、电容,与其焊盘连接的印制线最好从焊盘中央位置对称引出,且与焊盘连接的印制线必须具有一样的宽度,对付线宽小于0.3mm(12mil)的引出线可以不考虑此条规定
2. 与较宽印制线连接的焊盘,中间最好通过一段窄的印制线过渡(0805及其以下封装)
3. 线路应只管即便从SOIC、PLCC、QFP、SOT等器件的焊盘的两端引出
丝印
1. 器件位号是否遗漏,位置是否能精确标识器件
2. 器件位号是否符合公司标准哀求
3. 确认器件的管脚排列顺序、第1脚标志、器件的极性标志、连接器的方向标识的精确性
4. 母板与子板的插板方向标识是否对应
5. 背板是否精确标识了槽位名、槽位号、端口名称、护套方向
6. 确认设计哀求的丝印添加是否精确
7. 确认已经放置有防静电和射频板标识(射频板利用)
编码/条码
1. 确认PCB编码精确且符合公司规范
2. 确认单板的PCB编码位置和层面精确(该当在A面左上方,丝印层)
3. 确认背板的PCB编码位置和层面精确(该当在B右上方,外层铜箔面)
4. 确认有条码激光打印白色丝印标示区
5. 确认条码框下面没有连线和大于0.5mm导通孔
6. 确认条码白色丝印区外20mm范围内不能有高度超过25mm的元器件
过孔
1. 在回流焊面,过孔不能设计在焊盘上(常开窗的过孔与焊盘的间距应大于0.5mm (20mil),绿油覆盖的过孔与焊盘的间距应大于0.1 mm (4mil),方法:将Same Net DRC打开,查DRC,然后关闭Same Net DRC)
2. 过孔的排列不宜太密,避免引起电源、地平面大范围断裂
3. 钻孔的过孔孔径最好不小于板厚的1/10
工艺
1. 器件布放率是否100%,布通率是否100%(没有达到100%的须要在备注中解释)
2. Dangling线是否已经调度到最少,对付保留的Dangling线已做到逐一确认
3. 工艺科反馈的工艺问题是否已仔细查对
大面积铜箔
1. 对付Top、bottom上的大面积铜箔,如无分外的须要,运用网格铜(单板用斜网,背板用正交网,线宽0.3mm (12 mil)、间距0.5mm (20mil))
2. 大面积铜箔区的元件焊盘,应设计成花焊盘,以免虚焊;有电流哀求时,则先考虑加宽花焊盘的筋,再考虑全连接
3. 大面积布铜时,该当只管即便避免涌现没有网络连接的去世铜(孤岛)
4. 大面积铜箔还需把稳是否有造孽连线,未报告的DRC
测试点
1. 各种电源、地的测试点是否足够(每2A电流至少有一个测试点)
2. 确认没有加测试点的网络都是经确认可以进行精简的
3. 确认没有在生产时不安装的插件上设置测试点
4. Test Via、Test Pin是否已Fix(适用于测试针床不变的改板)
DRC
1. Test via 和Test pin 的Spacing Rule应先设置成推举的间隔,检讨DRC,若仍有DRC存在,再用最小间隔设置检讨DRC
2. 打开约束设置为打开状态,更新DRC,查看DRC中是否有不许可的缺点
3. 确认DRC已经调度到最少,对付不能肃清DRC要逐一确认
光学定位点
1. 确认有贴装元件的PCB面已有光学定位符号
2. 确认光学定位符号未压线(丝印和铜箔走线)
3. 光学定位点背景需相同,确认整板利用光学点个中心离边≥5mm
4. 确认整板的光学定位基准符号已授予坐标值(建议将光学定位基准符号以器件的形式放置),且因此毫米为单位的整数值。
5. 管脚中央距<0.5mm的IC,以及中央距小于0.8 mm(31 mil)的BGA器件,应在元件对角线附近位置设置光学定位点
阻焊检讨
1. 确认是否有分外需求类型的焊盘都精确开窗(尤其把稳硬件的设计哀求)
2. BGA下的过孔是否处理成盖油塞孔
3. 除测试过孔外的过孔是否已做开小窗或盖油塞孔
4. 光学定位点的开窗是否避免了露铜和露线
5. 电源芯片、晶振等需铜皮散热或接地屏蔽的器件,是否有铜皮并精确开窗。由焊锡固定的器件应有绿油阻断焊锡的大面积扩散
出加工文件
钻孔图
1. Notes的PCB板厚、层数、丝印的颜色、翘曲度,以及其他技能解释是否精确
2.叠板图的层名、叠板顺序、介质厚度、铜箔厚度是否精确;是否哀求作阻抗掌握,描述是否准确;叠板图的层名与其光绘文件名是否同等
3. 将设置表中的Repeat code 关掉,钻孔精度应设置为2-5
4. 孔表和钻孔文件是否最新(改动孔时,必须重新天生)
5. 孔表中是否有非常的孔径,压接件的孔径是否精确;孔径公差是否标注精确
6. 要塞孔的过孔是否单独列出,并标注“filled vias”
光绘
1. 光绘文件输出只管即便采取RS274X格式,且精度应设置为5:5
2. art_aper.*** 是否已最新(274X可以不须要)
3. 输出光绘文件的log文件中是否有非常报告
4. 负片层的边缘及孤岛确认
5. 利用光绘检讨工具检讨光绘文件是否与PCB 符合(改板要利用比对工具进行比对)
文件齐套
1. PCB文件:产品型号_规格_单板代号_版本号.brd
2. 背板的衬板设计文件:产品型号_规格_单板代号_版本号-CB[-T/B].brd
3. PCB加工文件:PCB编码.zip(含各层的光绘文件、光圈表、钻孔文件及ncdrill.log;拼板还须要有工艺供应的拼板文件.dxf),背板还要附加衬板文件:PCB编码-CB[-T/B].zip(含drill.art、.drl、ncdrill.log)
4. 工艺设计文件:产品型号_规格_单板代号_版本号-GY.doc
5. SMT坐标文件:产品型号_规格_单板代号_版本号-SMT.***(输出坐标文件时,确认选择 Body center,只有在确认所有SMD器件库的***是器件中央时,才可选Symbol origin)
6. PCB板构造文件:产品型号_规格_单板代号_版本号-MCAD.zip(包含构造工程师供应的.DXF与.EMN文件)
7. 测试文件:产品型号_规格_单板代号_版本号-TEST.ZIP(包含testprep.log 和 untest.lst或者.drl测试点的坐标文件)
8. 归档图纸文件:产品型号规格-单板名称-版本号.pdf(包括:封面、首页、各层丝印、各层线路、钻孔图、背板含有衬板图)
标准化
1. 确认封面、首页信息精确
2. 确认图纸序号(对应PCB各条理序分配)精确的
3. 确认图纸框上PCB编码是精确的













